闲谈真空镀膜之—化学气相沉积CVD
CVD
化学气相沉积(Chemical Vapor Deposition,CVD)是把一种或几种含有构成薄膜元素的化合物、单质气体通入放置有基材的反应室,借助空间气相化学反应在基体外观上沉积固态薄膜的技术。

主要特点
-
化学反应或热分解;
-
膜中所有材料都来自外部的源;
-
反应物必须以气相情势参与反应;
-
成膜温度较低
-
膜层成分、纯度、密度均可控
-
绕镀性好,适合复杂外形衬底
-
适用于金属、合金、陶瓷、化合物等各类材料

常见的几种CVD
各类CVD反应的区别重要在于环境压力的高低和输入能量方式的不同。
按压力分
根据压力分,重要有常压CVD(APCVD)、亚常压CVD(SACVD)、低压CVD(LPCVD)、超高真空CVD(UHCVD),科研和工业中应用较多的是APCVD和LPCVD。
1APCVD
Atmospheric Pressure CVD,在压力接近常压下进行CVD反应的一种沉积方式。工作压力接近一个大气压,是最初最简单的CVD技术。属于质量传输限定CVD工艺的一种,必须保证反应气体能等量到达每片衬底。
好处
-
所需的体系简单
-
沉积速度快
瑕玷
-
均匀性较差,
-
台阶覆盖能力差
一样平常用于厚的介质沉积,工业上多用于钝化珍爱处理。
2LPCVD
Low Pressure Chemical Vapor Deposition,原理与APCVD基原形同,不同的是工作气压比较低,属于反应速度限定CVD工艺的一种。因为工作气压降低,反应气体的扩散速度和均匀性均较APCVD大幅进步,因此薄膜的沉积速度快、质量高。适于单晶硅、多晶硅和氮化硅等超大规模集成电路的制造。
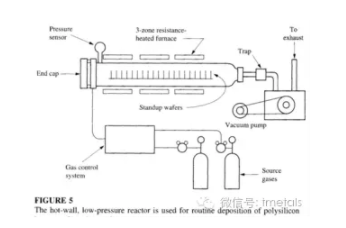
好处
-
可正确控制膜层的成分和结构
-
与常压CVD比,薄膜均匀性较好
瑕玷
-
对设备要求高,须有正确的压力控制体系,成本高
-
工作温度高
按能量方式分
根据输入能量方式分重要有热化学气相沉积(TCVD)、等离子体加强CVD(PECVD)、高密度等离子体CVD(HDPCVD)、激光诱导CVD(LCVD)等。
1TCVD
采用衬底加热的方法促进化学反应,是化学气相沉积的经典方法。一样平常采用电阻加热,高频感应加热和辐射加热等方式,反应温度在800~2000℃之间,对衬底的耐热性要求较高。
根据加热区域不同又分为热壁法和冷壁法。
热壁法:一样平常采用电阻加热的方式,加热区作用于反应腔壁,工作区和衬底均被加热。
好处:设备结构简单
瑕玷:腔壁容易沉积薄膜,降消沉积服从。
冷壁法:只加热衬底,一样平常采用感应加热、红外加热等方式实现。
好处:沉积只在衬底外观进行,服从高
瑕玷:设备结构复杂,部分技术将加热源置于腔体内部,容易带来污染。
2PECVD
Plasma Enhanced Chemical Vapor Deposition,借助微波或射频等使含有薄膜组成原子的气体电离,在局部形成等离子体,行使等离子体的活性,促进化学反应,在较低温度下沉积化合物薄膜。常用的有直流等离子体、射频等离子体、微波等离子体、脉冲等离子体等。
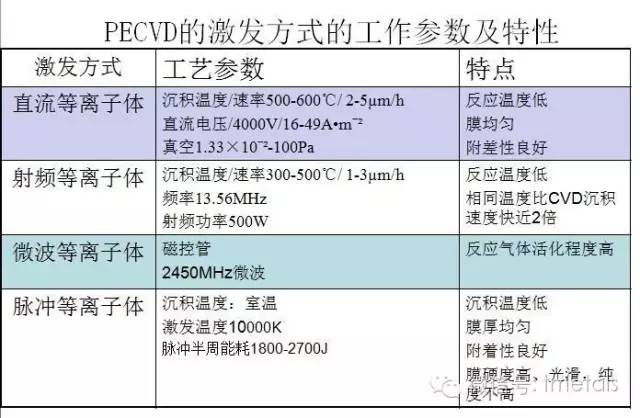
好处
-
沉积温度低
-
沉积速率快
-
成膜质量好
-
针孔较少,不易龟裂
瑕玷
-
设备成本高
-
噪音、辐射和有害气体污染
-
对小孔孔径内外观难以涂覆
3LCVD
LCVD是指行使激光束的光子能量激发和促进化学反应,实现薄膜沉积的化学气相沉积技术。
激光在反应中的作用有两种,加热衬底或直接作用于气体分子使其分解。
好处
-
较常规CVD沉积温度低
-
避免高能粒子薄膜的损伤
-
薄膜结构和纯度更高
几种常用CVD的对比

MOCVD
金属有机物CVD(MOCVD),是行使金属有机化合物热分解反应进行气相外延生长的方法,通常将含有外延材料组分的金属有机化合物和氢化物(或其他反应气体)质料气体输运到反应室,在常压或低压(10-100Torr)下通H2的冷壁石英(不锈钢)反应室中进行反应成膜。多用于Ⅲ-V族、Ⅱ-Ⅵ族化合物半导体以及它们的多元固溶体的外延生长。

好处
-
沉积温度低
-
适用范围广,可生长几乎所有的化合物和合金半导体
-
可实现化合物的外延生长
瑕玷
-
沉积速度慢,仅适宜沉积微米级的外观层
-
质料的毒性较大
ALD
Atomic Layer Deposition 原子层沉积,又叫原子层外延(atomic layer epitaxy),一种特别的CVD,可以将物质以单原子膜情势逐层沉积的方法,每次反应只沉积一层原子。
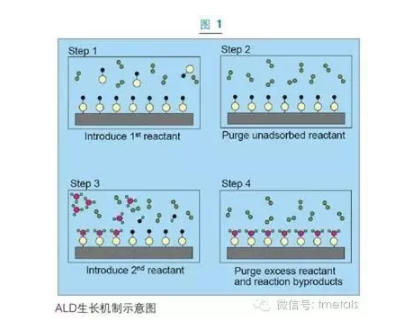
简单的说就是先将衬底外观进行活性处理,沉积薄膜时先通入将第一种反应物使衬底外观饱和吸附,将多余的源气体抽除干净后,再通入第二种反应物使之在衬底外观反应成膜,将剩余的反应物和反应副产品消灭干净。再重复上述过程进行下一层原子沉积。
好处
-
薄膜质量高,同等性好
-
薄膜成分可正确控制
-
厚度均匀
瑕玷
-
涉及复杂的外观化学过程,工艺控制难度大
-
沉积速率低
随着集成电路尺寸的赓续降低,所需膜层厚度降至纳米级别,ALD薄膜的均匀性和同等性的好处越来越紧张,沉积速率的题目已经不再成为一个题目。可以预见其在电子信息和纳米材料领域将会有更大的作为。
常用的CVD技术就简单的说道这里吧!
正是这些看不见的薄膜成就了我们的时代,随着技术的发展,信赖还会有更多、更不可思议的制备方法涌现出来,让我们拭目以待吧!

随着电子产品防水需求的不断提高,从原先的 IP54到现在的IP67IP68等级!市场上出现了防水透气膜和防水透音膜,目前这两种不同的材料应用被搞混了,今天便与大家一起讨论防水透气
最近各地降雨量激增,所以手机就难免会沾点水,作为生活中不可或缺的电子产品,防水已经成为一个十分重要重要功能,而且个人对目前的IP68手机市场是相当不满意的。为什么?太贵
自然界中荷叶具有出淤泥而不染的典型不沾水特性(学术上称为Cassie-Baxter状态),具有自清洁、抗结冰、减阻、抗腐蚀等广泛应用价值,而玫瑰花瓣则具有水滴高粘附特性(称为Wenze

派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理
派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理

高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料
高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料

耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层
耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层

真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天
真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天

亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料
亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料

台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效
台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效


